半導体製造に向けて、10nm以下の微小欠陥を高感度で検出する技術を開発
機械学習を活用し、品質管理と生産効率の向上に貢献
日立は、半導体製造プロセスにおける10nm*1以下の微小欠陥を高感度に検査する新たな画像処理技術を開発しました。この技術は機械学習*2を活用し、高感度な欠陥検出と回路レイアウトに応じた検出感度の調整により、極めて小さな欠陥を効率的に検査します。本技術により、半導体業界における品質管理と生産効率の向上に貢献します。
なお、開発した技術の詳細は、2025年2月23日から27日に開催されるSPIE Advanced Lithography + Patterning 2025で発表される予定です。
■背景および課題
高性能な半導体デバイスの需要が増加する中、半導体製造業界では製造プロセスにおける品質管理の重要性が増しています。特に、デバイスの信頼性と生産効率に直接影響を与える欠陥のサイズも微小になっているため、欠陥検査の高感度化が求められています。
■技術の特長
今回、日立は、日立ハイテクの協力のもと、これまでに培ってきた画像処理、機械学習、データサイエンスなどの知識を活用し、以下の特長を持つ半導体製造向けの欠陥検査技術を開発しました(図1)。
1. 機械学習を用いた高感度な欠陥検出技術
走査型電子顕微鏡(SEM)を用いて撮像した画像から微小欠陥を検出する技術を開発し、評価用サンプルに含まれる10nm以下の欠陥を高感度に検出可能なことを確認しました。この技術は、事前学習ステップとして、良品の画像にノイズを加えた劣化画像のデータを多数生成し、そこから良品画像の再構成に有効なデータの特徴を機械学習します。実際の検査時には、欠陥を含む画像から良品画像を自動で再構成し、再構成前後の画像を比較することにより数画素程度の微小な欠陥を高感度に検出します。
2. 回路レイアウトに応じた検出感度調整による過検出*3の抑制
検出すべき欠陥サイズの微小化に伴い製造ばらつき(非欠陥)との判別が困難となり、過検出の抑制が課題となります。そこで、回路パターンのレイアウトを機械学習を用いて分類する技術を開発しました。レイアウトに応じた検出感度調整を行うことで、特定の回路パターン上で生じる過検出を低減します。これにより、製造ばらつきと欠陥の正確な判別が可能となり、過検出を90%以上*4抑制しました。
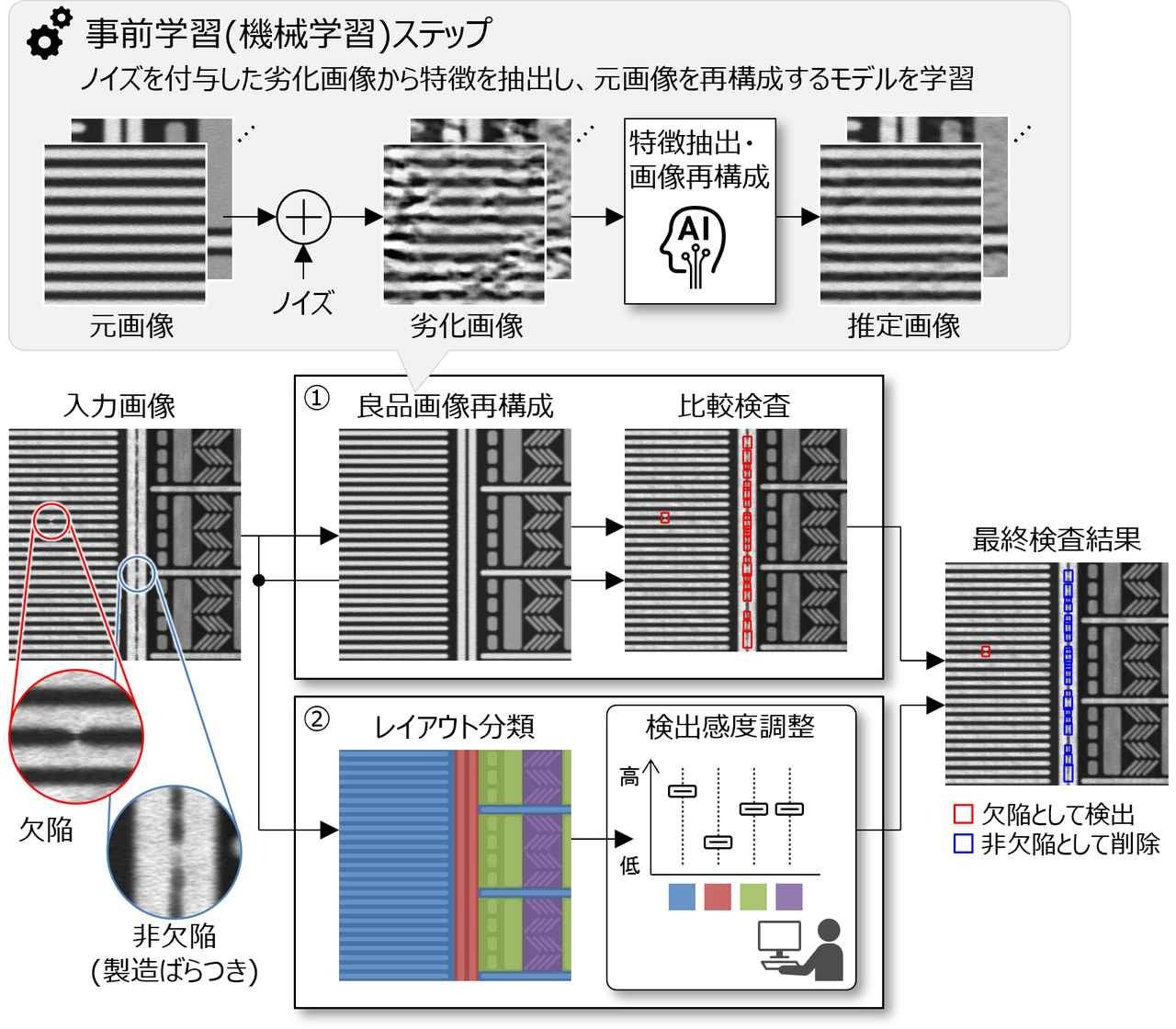
■今後の展望
この技術により、日立は半導体製造業界における品質管理と生産効率の向上に寄与し、高性能デバイスの安定供給を支援します。
日立は製造業界のデジタル化・DX化の進展に貢献するために、今後も欠陥検査をはじめとした画像処理技術の高度化を進めます。
*1 10億分の1メートル、1mmの100万分の1。
*2 アルゴリズムを使い特定分野の大量のデータを解析することで、その中に規則性や関係性を見つけ出す手法。
*3 正常箇所を検査装置が不良と判定すること。
*4 評価用サンプルを用いた評価における数値。
■関連情報
■照会先
株式会社日立製作所 研究開発グループ
すべての画像
- 種類
- 商品サービス
- ビジネスカテゴリ
- 電子部品・半導体・電気機器
- ダウンロード