TOPPAN、「電子機器トータルソリューション展 2025」に出展
FC-BGAサブストレートや次世代半導体パッケージ部材を展示
TOPPANホールディングスのグループ会社であるTOPPAN株式会社(本社:東京都文京区、代表取締役社長:大矢 諭、以下 TOPPAN)は、2025年6月4日(水)から6日(金)に開催される「電子機器トータルソリューション展 2025」(会場:東京ビッグサイト)に出展します。
本展示会は、電子回路・実装技術や、センサー・ウェアラブル技術等の新しいコンテンツとソリューション等の展示に加え、技術情報の提供・提案をはかり、併せて電子回路業界および関連業界全体の発展に寄与する、国内外に広く認知される展示会です。
TOPPANブースでは、FC-BGAサブストレートや、次世代半導体パッケージ関連の技術や部材などの展示・紹介を行います。

■主な展示内容
① FC-BGAサブストレート

FC-BGA(Flip Chip-Ball Grid Array)サブストレートは、LSIチップの高速化、多機能化を可能にする高密度半導体パッケージ基板です。活用される分野は産業機器から民生品まで幅広く、特にI/O数(信号数)の多いデジタル機器に用いられています。今回のTOPPANブースでは、生成AIや通信機器分野の先端LSIに適用されるFC-BGAサブストレートとして、チップレット構造(※1)に対応する次世代半導体パッケージ向けFC-BGA、およびLSIと光デバイスの近接実装に対応する高速データ伝送FC-BGAを展示します。
② 次世代半導体パッケージ
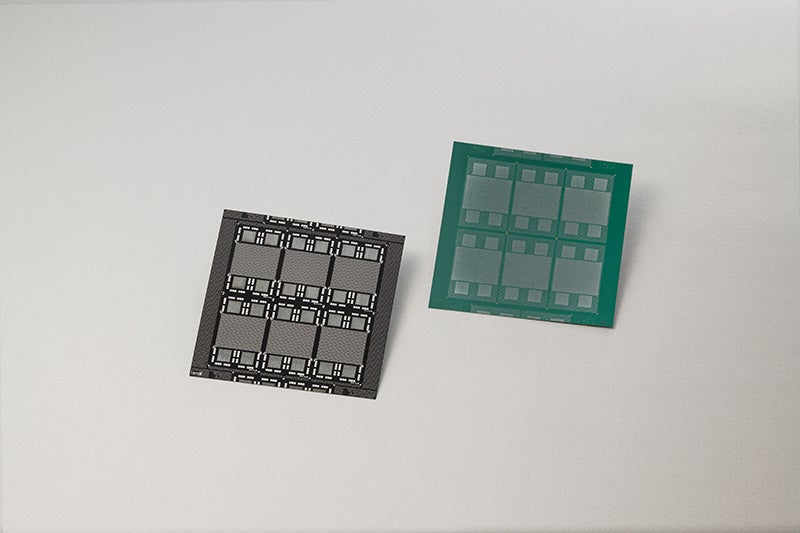
生成AIの機能は日進月歩で進化し、LSIのデータ処理は複雑化の一途を辿っています。 従来のFC-BGAサブストレートだけでは対応が困難となりつつある高集積化や伝送帯域の拡大などに向けて、TOPPANはガラスや有機材料を用いた次世代半導体パッケージの開発に注力しています。今回のTOPPANブースでは、貫通孔と高精度なキャビティ加工(※2)を施したガラスパネル基板や、コアレス有機RDLインターポーザー(※3)など、次世代半導体パッケージ部材、技術を紹介します。
■「電子機器トータルソリューション展 2025」について
・会期: 2025年6月4日(水)~6日(金)10:00~17:00
・会場:東京ビッグサイト 東7ホール
※TOPPANは「JPCA Show 2025」に出展(東7ホール/小間番号7D-02)
・主催:一般社団法人日本電子回路工業会
・公式サイト:https://www.jpcashow.com/show2025/index.html
※1: 複数の半導体チップを基板上で再配線する半導体パッケージング技術
※2: 基板上に部品等を内蔵するスペースを設ける技術
※3: 貫通電極によって表裏の回路を電気的に接続するために用いられる基板
* 本ニュースリリースに記載された商品・サービス名は各社の商標または登録商標です。
* 本ニュースリリースに記載された内容は発表日現在のものです。その後予告なしに変更されることがあります。
以 上
このプレスリリースには、メディア関係者向けの情報があります
メディアユーザー登録を行うと、企業担当者の連絡先や、イベント・記者会見の情報など様々な特記情報を閲覧できます。※内容はプレスリリースにより異なります。
すべての画像
