次世代半導体パッケージのコンソーシアム27社で「JOINT3」設立
~活動拠点を開設し、515 x 510mmパネルレベル有機インターポーザー試作ラインを構築~
株式会社レゾナック(代表取締役社長 CEO:髙橋秀仁、以下、当社)は、日本、米国、シンガポール等の半導体材料・装置・設計企業27社(当社含む)による共創型評価プラットフォーム「JOINT3」を設立しました。半導体材料・装置・設計の分野において世界トップクラスの企業が集結し、515 x 510mmサイズのパネルレベル有機インターポーザー試作ラインを用いて、パネルレベル有機インターポーザーに適した材料・装置・設計ツールの開発を推進します。
当社は、下館事業所(南結城)(茨城県結城市)内に本プラットフォームの活動拠点となる「先端パネルレベルインターポーザーセンター『APLIC(Advanced Panel Level Interposer Center)』」を開設し、APLIC内に本試作ラインを構築し、2026年に稼働を開始する予定です。実構造に近い検証結果を得ることで、参画企業の開発を加速します。
昨今、市場が急拡大している生成AIや自動運転を実現する次世代半導体においては、後工程のパッケージング技術がキーテクノロジーのひとつとなっています。なかでも、複数の半導体チップを並列に配置し、インターポーザー(中間基板)を介して接続し実装した2.xDパッケージは、データ通信の容量増加、高速化に伴い、さらに需要が拡大する見込みです。インターポーザーは、半導体の性能向上に伴いそのサイズが大型化しており、シリコンインターポーザーから有機材料を用いた有機インターポーザーへの移行が進んでいます。製造方法に関しては、円形ウェハから四角片を切り出す手法が主流ですが、インターポーザーのサイズが大型化することで、ウェハあたりのインターポーザーの取り数が減少するという課題が生じています。この課題に対処するため、円形のウェハ形状から四角いパネル形状へ変更し、インターポーザーの取り数を増加させる製造プロセスが注目されています。
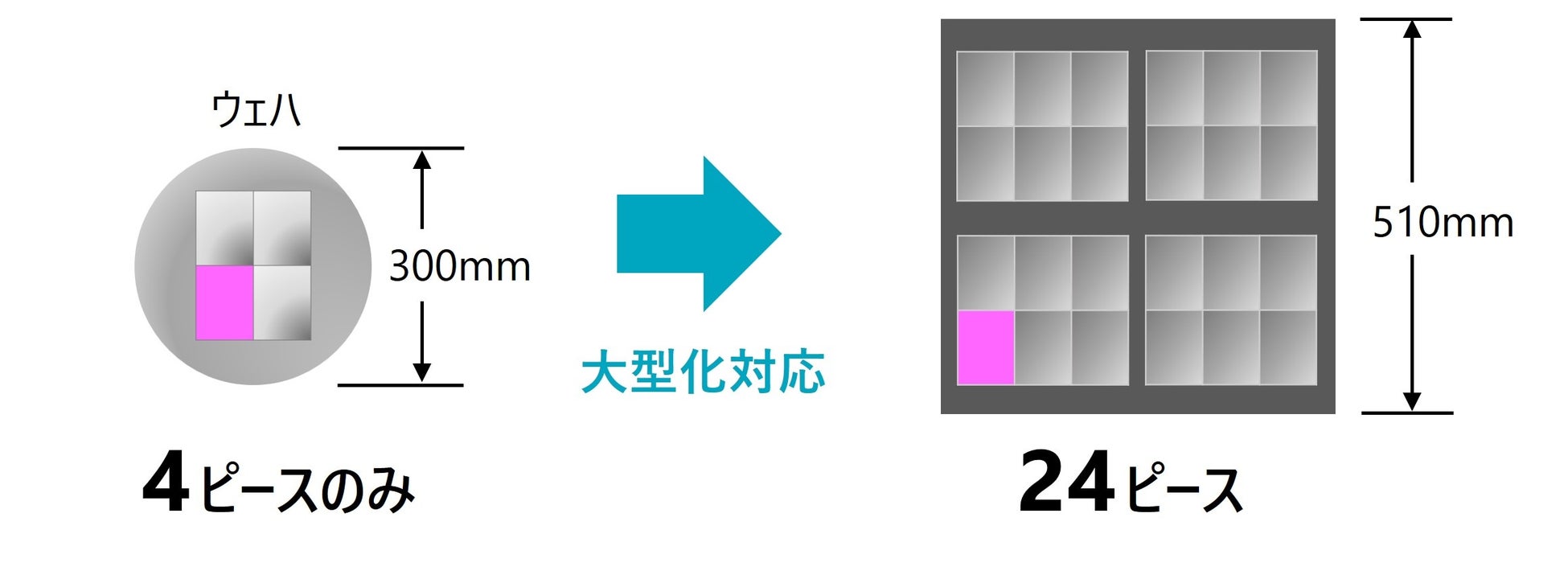
JOINT3において、当社は、技術開発テーマの取りまとめ、試作ラインの設備の運営など、JOINT3の推進を行うとともに、参画企業との共創により、パネルレベル有機インターポーザーに適した材料開発を推進します。
JOINT3の設立について、株式会社レゾナック・ホールディングス 代表取締役社長 CEOの髙橋秀仁は、「JOINT3には、各領域で世界トップクラスの企業が集結しています。各社が持つ強みやノウハウを結集し、補完し合うことで、これまで到達できなかった領域への挑戦が可能になります。この挑戦は、単なる技術開発に留まらず、社会課題を解決するソリューションの創出へとつながっていきます。今後の展開にご期待ください。」と述べています。
参画企業の東京エレクトロン株式会社 執行役員 コーポレートイノベーション本部 ディビジョンオフィサーの瀬川澄江氏は、「AI向け半導体の進化を支える先端パッケージ技術は、高速信号伝達と消費電力低減のための微細化、大容量搭載を可能にする大型化が鍵です。JOINT3のインターポーザー技術と日本の優れた材料・加工技術の融合を通じて、高品質で信頼性の高い製造を可能とし、AI半導体のさらなる発展を共に目指します。」と述べています。
また、同じく参画企業のウシオ電機株式会社 グループ上級執行役員のWilliam F. Mackenzie氏は、「アドバンストパッケージはエコシスムでのイノベーションやコラボレーションを要する新しい時代に突入しています。リソグラフィはこのような挑戦を達成するための重要な役割を担っており、弊社は、デジタルリソグラフィ技術やJOINT3におけるパートナーシップを通じて、高精度で高性能なパッケージ技術を実現して参ります。」と述べています。

当社は、半導体の製造装置・材料メーカーの枠を超えて進めてきた半導体パッケージ技術開発のコンソーシアム「JOINT」、および「JOINT2」、また、米国シリコンバレーで進めている、「US-JOINT」で得た知見を生かし、次世代半導体パッケージの技術革新に貢献していきます。


このプレスリリースには、メディア関係者向けの情報があります
メディアユーザー登録を行うと、企業担当者の連絡先や、イベント・記者会見の情報など様々な特記情報を閲覧できます。※内容はプレスリリースにより異なります。
すべての画像
