ナノインプリントリソグラフィ技術を応用したウエハー平坦化技術を世界で初めて実用化 先端半導体製造に求められる平坦度を飛躍的に向上
キヤノンは、ナノインプリントリソグラフィ(以下、NIL)技術を応用し、ウエハーを平坦化する「Inkjet-based Adaptive Planarization」(以下、IAP)技術を開発し、世界で初めて(※1)実用化しました。ロジックやメモリーなどの先端半導体製造現場での活用に向けて、2027年中にIAP技術を用いた装置の製品化を目指します。
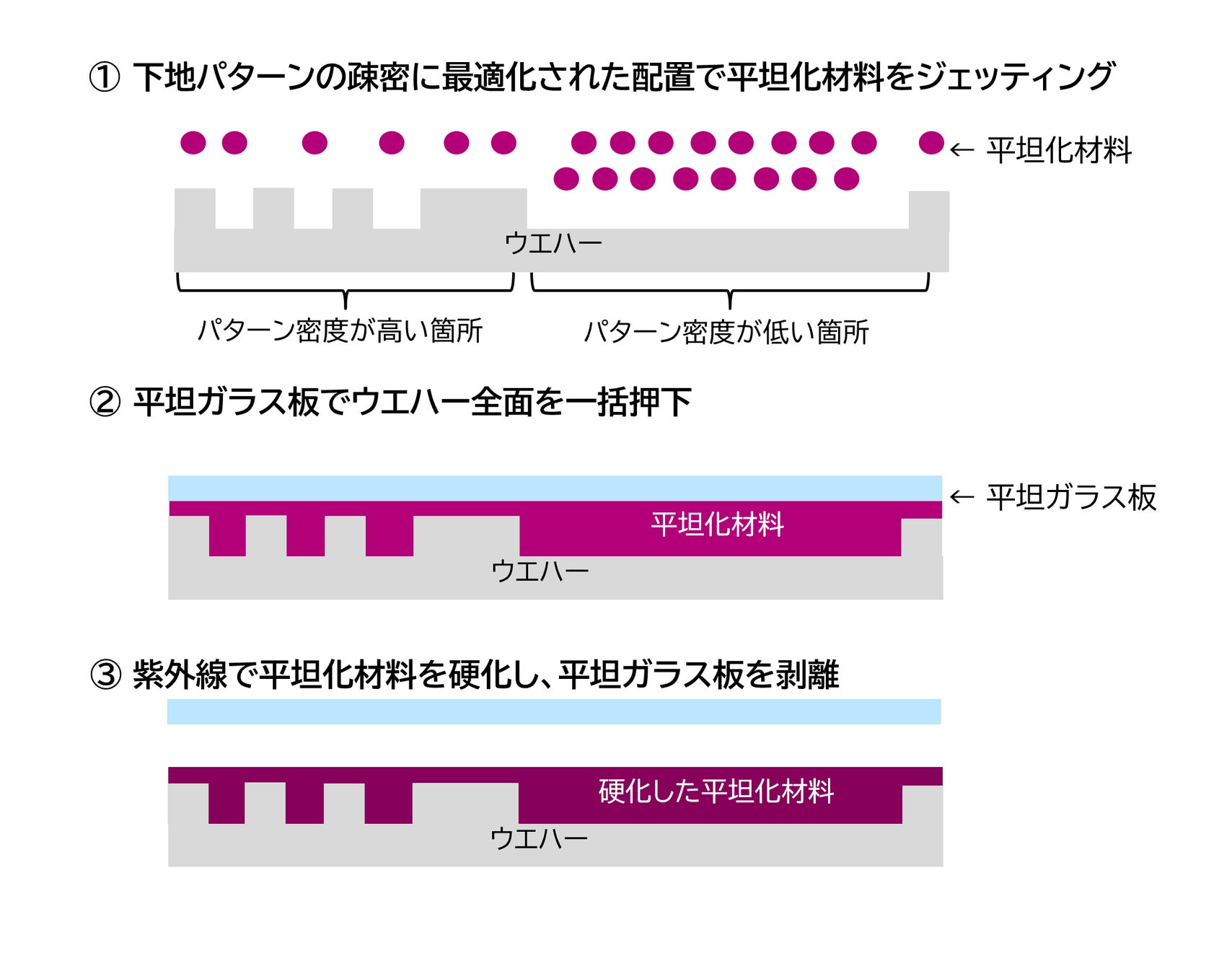
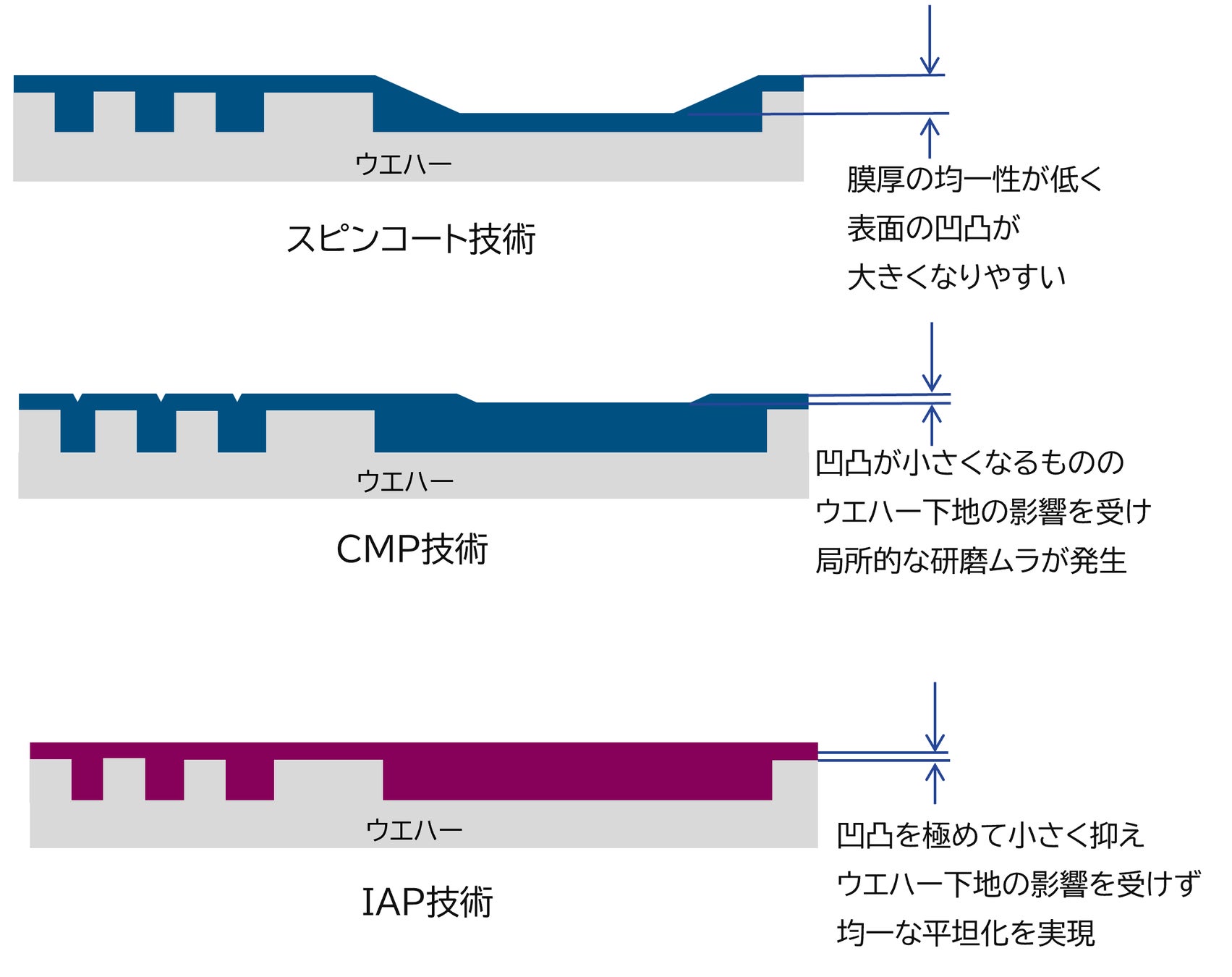
半導体製造では、成膜や配線などの工程を重ねる中で生じるウエハー表面の凹凸を均一に整える、平坦化工程が不可欠です。特に、微細化や3D化が進む先端半導体では、ウエハー表面のわずかな凹凸が、CD(※2)誤差やパターンエッジの位置ずれにつながり、歩留まりや生産性に大きな影響を与えることから、これまで以上に高精度な平坦化技術が求められています。現在主流の平坦化手法は、薄膜を形成し表面をなだらかにするスピンコート技術や、研磨を繰り返すCMP(Chemical Mechanical Polishing)技術ですが、工程の複雑化やコスト増加が課題となっています。
キヤノンは、インクジェット方式でレジスト(樹脂)を塗布したウエハーに、回路パターンを刻み込んだマスク(型)をハンコのように押し当てて回路を転写するNIL技術を開発し、半導体製造装置「FPA-1200NZ2C」を2023年10月に発売しました。今回開発したIAP技術は、このNIL技術を平坦化用途に応用したものです。ウエハー表面の凹凸分布に応じて、インクジェット方式で平坦化材料(樹脂)を最適に配置し、その上から平坦ガラス板を押し当てます。これにより、凹凸の粗密や回路パターンの違いに左右されることなく、直径300mmのウエハー全面を一括の押印工程で高精度に平坦化することが可能です。ウエハー表面の凹凸を5nm以下に抑えることができ、後続の工程に不可欠な、より均一な層構造を実現します。
キヤノンは、今後も、半導体製造技術や装置に関する研究開発を進め、半導体の進化と製造現場の生産性向上に貢献していきます。
〈ご参考〉
キヤノン株式会社およびキヤノンナノテクノロジーズInc.は、2026年2月25日(水)に、San Jose Convention Centerで開催される「SPIE Advanced Lithography and Patterning Conference」において、IAP技術と初期段階での実用化結果を発表する予定です。
※1 2026年1月12日現在(キヤノン調べ)。
※2 Critical Dimension。半導体デバイス性能に影響する回路の最小寸法のこと。
このプレスリリースには、メディア関係者向けの情報があります
メディアユーザー登録を行うと、企業担当者の連絡先や、イベント・記者会見の情報など様々な特記情報を閲覧できます。※内容はプレスリリースにより異なります。
すべての画像
