Si基板上にルチル型二酸化ゲルマニウム(r-GeO₂)薄膜の作製に成功~次世代半導体材料r-GeO₂を安価に実現する道を拓く~
Patentix 株式会社(以下「当社」)は、新世代のパワー半導体材料として注目されているルチル型二酸化ゲルマニウム(r-GeO₂)薄膜をSi基板上に作製することに成功しました。これは次世代パワー半導体r-GeO₂基板の低コスト化を実現するための基礎となる重要な成果です。
【背景】
従来、パワー半導体の基板として安価なシリコン(Si:バンドギャップ1.12 eV)が広く使用されてきましたが、Siパワーデバイスはその物理限界に達しており、バンドギャップが3.3 eVのシリコンカーバイド(SiC)や3.4 eVの窒化ガリウム(GaN)などワイドバンドギャップ半導体を用いたパワーデバイスへの置き換えが進んでいます。近年、ルチル型二酸化ゲルマニウム(r-GeO₂)は炭化ケイ素(SiC)や窒化ガリウム(GaN)と比べてさらに大きなバンドギャップ(4.68eV)をもち、p型・n型の両伝導が可能と理論的に予想されていることから次世代パワー半導体向けの材料として期待を集めています。
当社はr-GeO₂結晶薄膜の作製に適したPhantom SVD(ファントム局所的気相成長)法を独自に開発し、これまでにTiO₂基板やSiC基板上などに高品質なr-GeO₂薄膜を成膜することに成功しております[1][2]。
半導体基板にはコスト競争力が強く要求されます。近年、コストダウンが進んでいるSiCですが、その製造には成長速度が遅い昇華法を用いることと、融点が非常に高く製造時に莫大な電力を消費することからSi基板に比べると高価になっています。一方、同じくワイドバンドギャップ半導体のGaNでは、Si基板上にヘテロエピ成長させた結晶薄膜を半導体層とするヘテロエピ基板(GaN on Si基板)によって低コスト化を実現しています。r-GeO₂もGaNと同様に、安価なSi基板上にヘテロエピ成長することで基板コストの低減が期待できますが、Siとr-GeO₂の結晶構造が異なるためこれまでの研究では薄膜成長が困難でした。
【成果】
当社はSi(100)基板上に成膜された導電性バッファー層の上に、Phantom SVD法を用いてr-GeO₂の結晶膜を成膜することに世界で初めて成功しました(図1)。
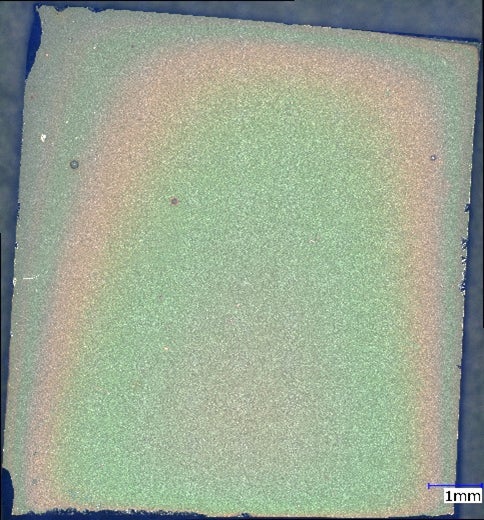
図1. Si(100)基板上の導電性バッファー層上に成膜されたr-GeO₂薄膜の外観写真

図2. GeO₂ on Si基板サンプルのXRDプロファイル
(※Si 200は本来禁制反射であるが検出されている)
作製したGeO₂ on Si基板サンプルのX線回折(XRD)測定を実施したところ、r-GeO₂に由来する明瞭なピークを確認することができました(図2)。
導電性バッファー層を採用することで、パワーデバイスの主流である縦型構造のデバイス作製が容易になります。当社はGeO₂ on Si基板を用いたパワーデバイスで、SiCパワー半導体の市場を置き換えることを目指しています。
今回の成果はGeO₂ on Si基板の実現可能性を示すもので、SiCよりも高性能である事が期待される次世代パワー半導体材料であるr-GeO₂基板を、SiC基板よりも安価に実現できる可能性が拓かれたことを意味します。
【将来展望】
今回の成果に基づいて引き続き研究開発を進め、Si基板上r-GeO₂薄膜のさらなる高品質化および基板の大口径化を進め、GeO₂ on Si基板の早期市場投入を目指します。また、今回成功したr-GeO₂ on Si基板を用いたパワーデバイスの試作及びその特性評価も推進してまいります。
[1] Y. Shimizu, et al., N-type conductivity in single-phase r-GeO₂ thin films., 2024 MRS Fall Meeting & Exhibit, SF04.15.08 (2024).
[2] 矢倉藤也 他,「r-GeO₂薄膜の4H-SiC基板上への結晶成長」, 第86回応用物理学会秋季学術講演会, 7a-N322-9 ,(2025)(投稿済み)
すべての画像
