r-GeO₂半導体におけるイオン注入によるn型導電性の付与に成功
~r-GeO₂パワーデバイスの製造技術の確立に大きく前進~
Patentix 株式会社(以下「当社」)は、次世代パワー半導体材料として注目されるルチル型二酸化ゲルマニウム(r-GeO₂)に、イオン注入プロセスによって絶縁性のr-GeO₂結晶膜にn型の導電性を付与すること成功しました。イオン注入プロセスはドーピングの濃度・位置・深さ精度が高く、パワーMOSFETなどの複雑なパワーデバイスの作製が容易になると期待されます。
【背景】
ルチル型二酸化ゲルマニウム(r-GeO₂)は、炭化ケイ素(SiC)や窒化ガリウム(GaN)と比べてさらに大きなバンドギャップ(4.68eV)をもち、p型・n型の両方導電性の制御が可能であると理論的に予測されており、高耐圧・高出力・高効率なパワー半導体デバイスを実現できる次世代の半導体材料として注目を集めています。
当社はこれまでに、PhantomSVD法を用いて成膜中にドナー不純物(アンチモン:Sb)を膜中に添加することで、電子密度にして約1020[cm-3]のr-GeO₂のn型導電性の制御に成功しています[1]。さらに、成膜中のドナー不純物導入によるn型制御技術を応用して、世界初のショットキーバリアダイオード(SBD)を試作し、そのダイオード動作の確認にも成功しております[2]。
一方、パワーMOSFETなどの複雑な構造を有するパワーデバイスを製造するためには、基板表面のドナー不純物濃度を精密に作り分ける技術が求められますが、成膜中のドナー不純物添加によるn型制御技術ではこの要求を満たすことは困難です。そのため、シリコン(Si)やSiCといった、従来の半導体でも広く利用されているイオン注入によるr-GeO₂結晶への不純物ドーピングの実現が望まれていました。
【成果】
当社が開発した独自の成膜技術であるPhantom SVD法によりTiO₂基板上に作製したアンドープの(意図的に不純物をドーピングしていない)r-GeO₂薄膜に対し、Sbのイオン注入を実施しました。図1にイオン注入の前後の外観写真と、面内における各箇所でのr-GeO₂膜厚の測定結果を示します。イオン注入プロセスの前後でr-GeO₂薄膜の膜厚に有意な変化は認められません。また、イオン注入前後のX線回折測定結果から、ルチル構造が保持されている事を確認しました。
イオン注入によるドナー不純物のドーピングを実施した領域では、シート抵抗が低下した確認されています。これはイオン注入プロセスで導入されたドナー不純物が活性化したことで、絶縁性のr-GeO₂結晶膜にn型の導電性を付与することに成功したものと考えられます。
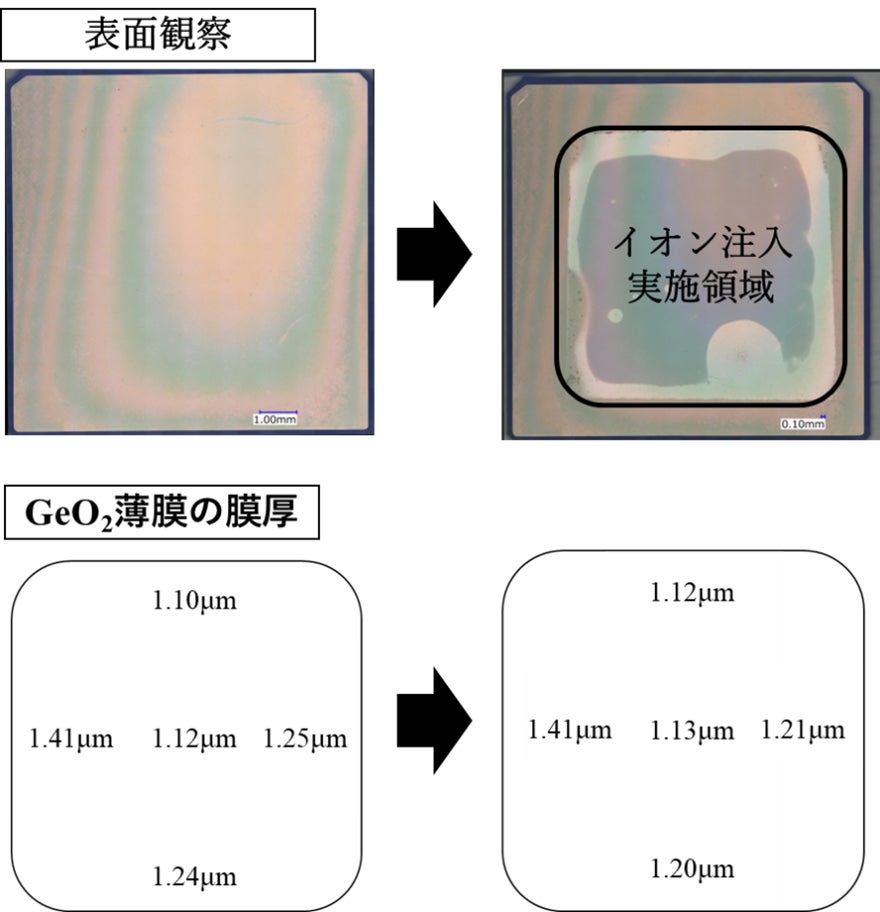
図1 : イオン注入の前後におけるr-GeO₂薄膜の表面の外観写真と面内における各箇所での膜厚の変化
(左:イオン注入前、右:イオン注入後)
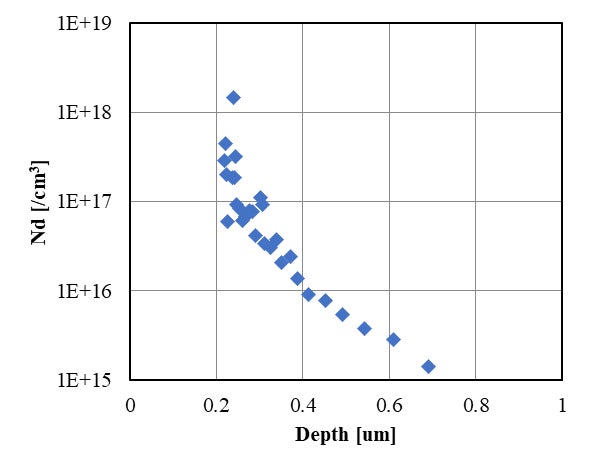
図2 : C-V特性から算出されたSbイオン注入領域における
r-GeO₂薄膜中のドナー不純物密度の深さ方向の依存性
イオン注入を実施した領域に電極を形成し、容量電圧(C-V)測定を実施したところ、イオン注入を実施した領域がn型の導電性を示すことが確かめられました。また、測定されたC-V特性からドナー不純物密度を解析したところ、図2に示すような分布を持つことが分かりました。この結果は、本サンプルのr-GeO₂膜中のドナー不純物が成膜時に導入されたのではなく、イオン注入プロセスによって膜の表面近傍に導入されたものであること示しています。
一方、今回イオン注入プロセスによって導入されたドナー不純物がSbかどうかについては検証が必要です。現在、電流電圧(I-V)特性などの測定の他、イオン注入プロセスによってr-GeO₂膜中にSbがどの程度導入されたかについて二次イオン質量分析法(SIMS)による不純物の分析を進めており、第86回応用物理学会秋季学術講演会にてr-GeO₂薄膜の構造評価や電気特性の評価結果の詳細について報告を予定しております[3]。
今回のイオン注入によるn型導電性の付与は、r-GeO₂という新しい半導体材料で脱炭素社会の実現に貢献する、という当社の目標における重要な一歩です。
【将来展望】
今後、r-GeO₂パワーデバイスの実用化に向けて、イオン注入プロセスを用いた不純物ドーピングの条件最適化、およびイオン注入プロセスを用いたr-GeO₂のパワーデバイスの試作を推進していきます。
[1] Y. Shimizu, et al., “N-type conductivity in single-phase r-GeO₂ thin films.”, 2024 MRS Fall Meeting & Exhibit, SF04.15.08 (2024).
[2] 清水悠吏 他, 「ルチル構造二酸化ゲルマニウム(r-GeO₂)のショットキーバリアダイオード特性」,第72回応用物理学会春季学術講演会, 15a-K403-11(2025).
[3] 清水悠吏 他,「イオン注入プロセスを用いたルチル構造二酸化ゲルマニウム(r-GeO₂)の特性評価」, 第86回応用物理学会秋季学術講演会 (2025) (投稿済).
すべての画像
